ВУЗ: Не указан
Категория: Не указан
Дисциплина: Не указана
Добавлен: 18.03.2024
Просмотров: 487
Скачиваний: 1
ВНИМАНИЕ! Если данный файл нарушает Ваши авторские права, то обязательно сообщите нам.
напряжения через поликремниевые затворы изменяются электрические потенциалы вблизи электродов.
До экспонирования – обычно, подачей определённой комбинации напряжений на электроды – происходит сброс всех ранее образовавшихся зарядов и приведение всех элементов в идентичное состояние.
Далее комбинация напряжений на электродах создаёт потенциальную яму, в которой могут накапливаться электроны, образовавшиеся в данном пикселе матрицы в результате воздействия света при экспонировании. Чем интенсивнее световой поток во время экспозиции, тем больше накапливается электронов в потенциальной яме, соответственно тем выше итоговый заряд данного пикселя.
После экспонирования последовательные изменения напряжения на электродах формируют в каждом пикселе и рядом с ним распределение потенциалов, которое приводит к перетеканию заряда в заданном направлении, к выходным элементам матрицы.
В общем виде конструкция ПЗС-элемента выглядит так: кремниевая подложка p-типа оснащается каналами из полупроводника n-типа. Над каналами создаются электроды из поликристаллического кремния с изолирующей прослойкой из оксида кремния. После подачи на такой электрод электрического потенциала, в обеднённой зоне под каналом n-типа создаётся потенциальная яма, назначение которой — хранить электроны. Фотон, проникающий в кремний, приводит к генерации электрона, который притягивается потенциальной ямой и остаётся в ней. Большее количество фотонов (яркий свет) обеспечивает больший заряд ямы. Затем надо считать значение этого заряда, именуемого также фототоком, и усилить его.
Существуют Матрицы:
 Вольт-амперная характеристика (ВАХ) p-n перехода, в основной своей части, как и ВАХ m-n контакта Шотки, описывается формулой Шокли (22).
Вольт-амперная характеристика (ВАХ) p-n перехода, в основной своей части, как и ВАХ m-n контакта Шотки, описывается формулой Шокли (22).
Подчиняющуюся этой закономерности ВАХ называют идеализированной, или теоретической ВАХ, рис. 16:
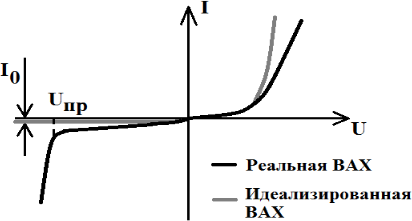
Рис. 16
ВАХ реальных p-n и m-n диодов сильно отклоняются от идеальной ВАХ в области больших обратных напряжений, когда возникает пробой (участок пробоя).
В области больших прямых токов отклонение обусловлено тем, что сопротивление заполненного носителями обеднённого слоя очень мало. При
этом сопротивление перехода в целом определяется сопротивлением прилегающих к переходу областей, в первую очередь, сопротивлением базы r б . У диодов Шотки отклонение реальной ВАХ от экспоненты при больших токах проявляется слабее, т.к. для них слабое легирование полупроводниковой области нехарактерно.
Значительное расхождение наблюдается также в допробойной части обратной ветви ВАХ. Согласно формуле Шокли при обратных напряжениях обратный ток неизменен и равен току насыщения I 0 . Однако в реальности на
этот ток накладываются ещё несколько токов, растущих с увеличением U обр . Одной из составляющих обратного тока является ток утечки I ут , который обусловлен движением носителей не в самом контакте, а по его поверхности. Поверхность полупроводника взаимодействует с окружающей средой и, обладая сводными валентными связями, способна захватывать посторонние атомы. Их валентность, вероятнее всего, будет отличаться от валентности
самого полупроводника, т.е. эти атомы будут для полупроводника донорными или акцепторными примесями. В результате поверхность окажется сильнолегированной и будет обладать повышенной электропроводностью. Ток утечки растёт с увеличением U обр и, складываясь с I 0, создаёт наклон допробойной части ВАХ.
Непрерывно растущие требования к электронным устройствам привели
к отказу от использования дискретных (отдельных) электронных элементов и к началу эпохи интегральных схем (ИС). В ИС все элементы и соединения межу ними изготавливаются на общем кристалле полупроводника и надежно защищены от внешних воздействий прочным герметичным корпусом. При такой технологии изготовления успешно решаются важнейшие задачи электроники. Основными из них являются обеспечение следующих свойств устройств:
Хотя на первом месте по значимости может казаться любое из
указанных свойств, именно требования к надёжности привели в своё время к отказу от дискретных элементов. При большом количестве таких элементов надёжность оказывалась недопустимо низкой из-за большого количества соединений, использования ручного труда и связанными с этим ошибками, недостаточной защищённостью элементов и соединений.
Первоначально всё, что связано с применением ИС, называлось
«микроэлектроника». В настоящее время утвердилось название
«электроника», которое охватывает области микроэлектроники, традиционной радиоэлектроники и уже появившейся наноэлектроники.
В процессе переключения транзисторных ключей заряжаются и
разряжаются так называемые паразитные ёмкости. Как правило, именно
этот переходной процесс ограничивает быстродействие. Паразитные ёмкости в МДП ИС это прежде всего, ёмкость между затвором и каналом и ёмкость транзистора по отношению к подложке. В ИС на биполярных транзисторах это ёмкости p-n переходов и также ёмкость по отношению к подложке.
Некоторую ёмкость по отношению к подложке имеют и соединительные проводники между транзисторами ИС. Условно можно считать, что на каждый ключ приходится некоторая суммарная ёмкость С.
На рис. 20 изображена схема ключа на комплементарных МДП-
транзисторах (КМДП-ключ). В нём нижний транзистор - с индуцированным n-каналом, верхний – с индуцированным p-каналом. Суммарная ёмкость С учитывает ёмкость затвор-канал транзисторов, их ёмкость по отношению к подложке, ёмкость соединения с нагрузкой и ёмкость самой нагрузки.
Нагрузкой такого ключа в КМДП ЦИС всегда является вход другого такого же ключа или несколько таких ключей. Так как затворы МДП транзисторов, т.е. входы ключей, изолированы от всего остального слоем диэлектрика, можно пренебречь активной составляющей сопротивления нагрузки и
считать сопротивление нагрузки ключа чисто ёмкостным.
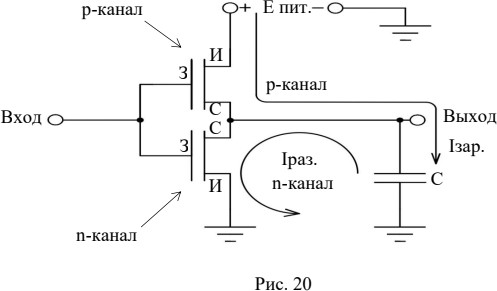
На рис. 21 представлены временные диаграммы КМДП-ключа при подаче на вход одиночного прямоугольного импульса.

Если входное напряжение Uвх = 0, у n-канального транзистора Uзи = 0,
у р-канального Uзи = - Епит. Поэтому нижний транзистор
закрыт, верхний открыт. Цепь от + Епит к земле разорвана, потребляемого тока нет.
Если Uвх = + Епит, нижний транзистор открыт, верхний закрыт. Потребляемого тока также нет. Поэтому в обоих статических (неизменяющихся) состояниях такой ключ тока и энергии не потребляет. Это делает КМДП-ключ «чемпионом» экономичности и объясняет его исключительно широкое распространение.
Небольшой потребляемый ток (ток заряда i зар) , возникает здесь только
на короткое время t 01, когда открывается верхний транзистор и через его канал заряжается суммарная ёмкость С. При этом С накопит энергию СU^2 /2 =
СЕ пит ^2 /2. Такая же энергия превратится в тепло при протекании i зар в канале верхнего транзистора. Когда состояние ключа изменяется на противоположное, возникает ток разряда i разр . Он протекает через канал нижнего транзистора, в котором накопленная в С энергия превращается в тепло. Следовательно, согласно (7),

средний расход энергии от источника питания на одно изменение состояния составит СЕ пит^2 /2. Поэтому у КМДП-ключа
Соотношение (9)

объясняет обе основные тенденции в разработке
ЦИС. Во-первых, это стремление к уменьшению суммарной ёмкости С, которое достигается уменьшением минимального топологического размера
w. Во-вторых, это уменьшение напряжения источника питания Е пит . Сегодня фотолитография обеспечивает w уже менее 10 нм, а напряжение источника питания ЦИС составляет менее 1 В.
Напряжение питания не может быть меньше порогового напряжения
До экспонирования – обычно, подачей определённой комбинации напряжений на электроды – происходит сброс всех ранее образовавшихся зарядов и приведение всех элементов в идентичное состояние.
Далее комбинация напряжений на электродах создаёт потенциальную яму, в которой могут накапливаться электроны, образовавшиеся в данном пикселе матрицы в результате воздействия света при экспонировании. Чем интенсивнее световой поток во время экспозиции, тем больше накапливается электронов в потенциальной яме, соответственно тем выше итоговый заряд данного пикселя.
После экспонирования последовательные изменения напряжения на электродах формируют в каждом пикселе и рядом с ним распределение потенциалов, которое приводит к перетеканию заряда в заданном направлении, к выходным элементам матрицы.
В общем виде конструкция ПЗС-элемента выглядит так: кремниевая подложка p-типа оснащается каналами из полупроводника n-типа. Над каналами создаются электроды из поликристаллического кремния с изолирующей прослойкой из оксида кремния. После подачи на такой электрод электрического потенциала, в обеднённой зоне под каналом n-типа создаётся потенциальная яма, назначение которой — хранить электроны. Фотон, проникающий в кремний, приводит к генерации электрона, который притягивается потенциальной ямой и остаётся в ней. Большее количество фотонов (яркий свет) обеспечивает больший заряд ямы. Затем надо считать значение этого заряда, именуемого также фототоком, и усилить его.
Существуют Матрицы:
-
Матрицы с полнокадровым переносом -
Полнокадровая матрица -
Матрицы с буферизацией кадра -
Матрицы с буферизацией столбцов -
Матрицы с ортогональным переносом изображения
Тринадцатый билет
13. Идеализированная и реальная вольтамперная характеристика m-n и p-n диодов.
Подчиняющуюся этой закономерности ВАХ называют идеализированной, или теоретической ВАХ, рис. 16:
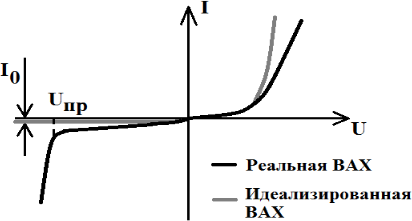
Рис. 16
ВАХ реальных p-n и m-n диодов сильно отклоняются от идеальной ВАХ в области больших обратных напряжений, когда возникает пробой (участок пробоя).
В области больших прямых токов отклонение обусловлено тем, что сопротивление заполненного носителями обеднённого слоя очень мало. При
этом сопротивление перехода в целом определяется сопротивлением прилегающих к переходу областей, в первую очередь, сопротивлением базы r б . У диодов Шотки отклонение реальной ВАХ от экспоненты при больших токах проявляется слабее, т.к. для них слабое легирование полупроводниковой области нехарактерно.
Значительное расхождение наблюдается также в допробойной части обратной ветви ВАХ. Согласно формуле Шокли при обратных напряжениях обратный ток неизменен и равен току насыщения I 0 . Однако в реальности на
этот ток накладываются ещё несколько токов, растущих с увеличением U обр . Одной из составляющих обратного тока является ток утечки I ут , который обусловлен движением носителей не в самом контакте, а по его поверхности. Поверхность полупроводника взаимодействует с окружающей средой и, обладая сводными валентными связями, способна захватывать посторонние атомы. Их валентность, вероятнее всего, будет отличаться от валентности
самого полупроводника, т.е. эти атомы будут для полупроводника донорными или акцепторными примесями. В результате поверхность окажется сильнолегированной и будет обладать повышенной электропроводностью. Ток утечки растёт с увеличением U обр и, складываясь с I 0, создаёт наклон допробойной части ВАХ.
28. Основные задачи электроники. Интегральные схемы. Наноэлектроника.
Непрерывно растущие требования к электронным устройствам привели
к отказу от использования дискретных (отдельных) электронных элементов и к началу эпохи интегральных схем (ИС). В ИС все элементы и соединения межу ними изготавливаются на общем кристалле полупроводника и надежно защищены от внешних воздействий прочным герметичным корпусом. При такой технологии изготовления успешно решаются важнейшие задачи электроники. Основными из них являются обеспечение следующих свойств устройств:
-
Высокая надежность при практически неограниченном и непрерывно растущем количестве элементов; -
Малые размеры и масса; -
Низкая себестоимость; -
Низкое энергопотребление.
Хотя на первом месте по значимости может казаться любое из
указанных свойств, именно требования к надёжности привели в своё время к отказу от дискретных элементов. При большом количестве таких элементов надёжность оказывалась недопустимо низкой из-за большого количества соединений, использования ручного труда и связанными с этим ошибками, недостаточной защищённостью элементов и соединений.
Первоначально всё, что связано с применением ИС, называлось
«микроэлектроника». В настоящее время утвердилось название
«электроника», которое охватывает области микроэлектроники, традиционной радиоэлектроники и уже появившейся наноэлектроники.
43. Ключ на комплементарных МДП транзисторах.
В процессе переключения транзисторных ключей заряжаются и
разряжаются так называемые паразитные ёмкости. Как правило, именно
этот переходной процесс ограничивает быстродействие. Паразитные ёмкости в МДП ИС это прежде всего, ёмкость между затвором и каналом и ёмкость транзистора по отношению к подложке. В ИС на биполярных транзисторах это ёмкости p-n переходов и также ёмкость по отношению к подложке.
Некоторую ёмкость по отношению к подложке имеют и соединительные проводники между транзисторами ИС. Условно можно считать, что на каждый ключ приходится некоторая суммарная ёмкость С.
На рис. 20 изображена схема ключа на комплементарных МДП-
транзисторах (КМДП-ключ). В нём нижний транзистор - с индуцированным n-каналом, верхний – с индуцированным p-каналом. Суммарная ёмкость С учитывает ёмкость затвор-канал транзисторов, их ёмкость по отношению к подложке, ёмкость соединения с нагрузкой и ёмкость самой нагрузки.
Нагрузкой такого ключа в КМДП ЦИС всегда является вход другого такого же ключа или несколько таких ключей. Так как затворы МДП транзисторов, т.е. входы ключей, изолированы от всего остального слоем диэлектрика, можно пренебречь активной составляющей сопротивления нагрузки и
считать сопротивление нагрузки ключа чисто ёмкостным.
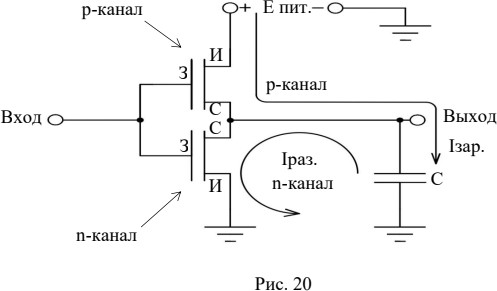
На рис. 21 представлены временные диаграммы КМДП-ключа при подаче на вход одиночного прямоугольного импульса.

Если входное напряжение Uвх = 0, у n-канального транзистора Uзи = 0,
у р-канального Uзи = - Епит. Поэтому нижний транзистор
закрыт, верхний открыт. Цепь от + Епит к земле разорвана, потребляемого тока нет.
Если Uвх = + Епит, нижний транзистор открыт, верхний закрыт. Потребляемого тока также нет. Поэтому в обоих статических (неизменяющихся) состояниях такой ключ тока и энергии не потребляет. Это делает КМДП-ключ «чемпионом» экономичности и объясняет его исключительно широкое распространение.
Небольшой потребляемый ток (ток заряда i зар) , возникает здесь только
на короткое время t 01, когда открывается верхний транзистор и через его канал заряжается суммарная ёмкость С. При этом С накопит энергию СU^2 /2 =
СЕ пит ^2 /2. Такая же энергия превратится в тепло при протекании i зар в канале верхнего транзистора. Когда состояние ключа изменяется на противоположное, возникает ток разряда i разр . Он протекает через канал нижнего транзистора, в котором накопленная в С энергия превращается в тепло. Следовательно, согласно (7),
средний расход энергии от источника питания на одно изменение состояния составит СЕ пит^2 /2. Поэтому у КМДП-ключа
Соотношение (9)
объясняет обе основные тенденции в разработке
ЦИС. Во-первых, это стремление к уменьшению суммарной ёмкости С, которое достигается уменьшением минимального топологического размера
w. Во-вторых, это уменьшение напряжения источника питания Е пит . Сегодня фотолитография обеспечивает w уже менее 10 нм, а напряжение источника питания ЦИС составляет менее 1 В.
Напряжение питания не может быть меньше порогового напряжения
