ВУЗ: Не указан
Категория: Не указан
Дисциплина: Не указана
Добавлен: 20.03.2024
Просмотров: 18
Скачиваний: 0
В1
-
Мета фотолітографії. Схема її технологічного процесу.
Суть процесу літографії полягає в тому, що чутливі до світла фоторезисти наносяться на поверхню підготованої підкладки і піддаються дії випромінювання (експонування). Використання спеціальної скляної маски з
прозорими та непрозорими полями (фотошаблону) приводить до локальної дії випромінювання на фоторезист, а отже і до локальної зміни його властивостей. При подальшому дії певних хімікатів відбувається усунення з
підкладки ділянок плівки фоторезисту, які піддались освітленню (проявлення). Таким чином, із плівки фоторезисту створюється захисна маска з рисунком, який повторює рисунок фотошаблону. На останній стадії здійснюється травлення поверхневого шару підкладки на
незахищених ділянках.
-
Практичнi способи проведення дифузiї: дифузія з використанням рідинних джерел домішки.
На рисунку 2.2 приведена схема установки для рідинних джерел домішок
При використанні рідинних джерел домішки, якими як правило служать галогеніди, установка для дифузії має одну високотемпературну зону – кварцеву піч 1 (800-1200˚С). Довжина труби, в якій містяться підкладки дорівнює 40 –60 см, діаметр ~20 см.
Для випаровування рідинного джерела достатньо підтримувати його температуру в інтервалі 20 – 40˚С.
Рисунок. 2.2. Схема установки дифузії для рідинних джерел домішок:
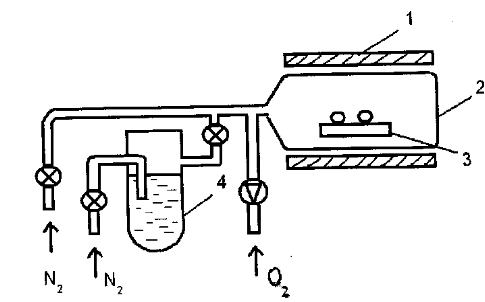
1 – трубчата піч;
2 – кварцева труба;
3 – підкладки;
4 – посудина з рідким джерелом домішки.
Найбільш широке вокористання в якості джерела знайшли галогеніди фосфору та бору (трихлористий фосфор PCI3, хлорокись фосфору POCl3, трибромистий бор BBr3).
В кварцеву трубу направляється три потоки газу:
1) основний потік азоту або аргону зі швидкістю 1000 см3/ хв;
2) слабий потік цього ж газу зі швидкістю 10 см3/ хв, цього ж газу, який попередньо пройшов через рідке джерело;
3) слабкий потік кисню зі швидкістю 15 см3/ хв.
При використанні рідинних джерел наявність кисню у складі газу-носія має принципове значення, оскільки приводить до утворення оксидів домішки. Так для BBr3 у зоні дифузії проходять наступні хімічні реакції:
-
4 BBr3 + 3 О2 = 2 В2О3 + 6 Br2
-
Si + О2 = SiО2
При взаємодії оксиду кремнію з оксидом бору утворюється сполука типу
-
m В2О3*n SiО2 – боросілікатне скло.
На поверхні кремнію виділяється бор з боросілікатного скла і при реакції
-
3 Si + 2 В2О3= 2 SiО2 + 4В
йде виділення дифундуючого в кремній бора.
-
Аналогічно проходять реакції для PCI3, POCl3, які використовують для дифузії фосфора:
-
4 PCI3 + 5 О2 = 2 Р2О5 + 6 CI2
-
4 POCl3 + 3 О2= 2 Р2О5 + 6 CI2
-
Si + О2 = SiО2
-
2Р2О3 + 5 Si = 5 SiО2 + 4 Р
-
m Р2О5∙n SiО2 - фосфоросілікатне скло.
-
Розглянуті хімічні реакції супроводжуються утворенням галогенідів, які здатні травити поверхню кремнію, а самі по собі є отруйними газами.
-
При достатньому вмісті кисню (~ 7L 10 %) травлення кремнію не відбувається завдяки росту кількості SiО2.
-
Недоліком дифузії є те, що і самі джерела і продукти реакції являються отруйними речовинами.
В2
-
Рентгенопроменева літографія.
При рентгенопроменевій літографії потік рентгенівського випромінювання (довжина хвилі 0,4–1,4 нм) спрямовується на шаблон, під яким розмішена
підкладка, покрита резистом, чутливим до зазначеного випромінювання (рис. 7). Час експонування становить декілька хвилин.
Для виготовлення шаблона, використовуються плівки кремнію товщиною декілька мікрометрів, прозорі для рентгенівського випромінювання. Негативне зображення рисунка мікросхем створюється із плівки золота товщиною близько 0,3 мкм, нанесеної на тонкий шар кремнію. Вибір золота обумовлений його максимальною здатністю поглинати рентгенівське випромінювання порівняно з іншими поширеними матеріалами. Під час
рентгенопременевої літографії суміщення рисунків можепроводитися двома способами: із використанням рентгенівського випромінювання та оптичним.
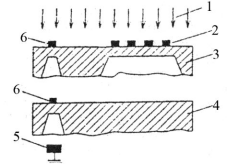
Рисунок 7 – Ілюстрація принципу рентгенопроменевої літографії: 1 – рентгенівське випромінювання; 2 – рисунок на основі плівки золота; 3 – кремнієвий шаблон; 4 – кремнієва підкладка; 5 – детектор рентгенівського
випромінювання; 6 – маркерні знаки
Мінімальний розмір елементів, одержаних рентгенопроменевою літографією, становить 0,1 мкм. Підвищення роздільної здатності обмежене утворенням
вторинних електронів, що поширюються на відстань близько 0,1 мкм і здатні виразити структурні зміни у резисті. Поряд із високою роздільною здатністю рентгенопроменева літографія має ряд переваг: нечутливість до забруднення, процес проходить у безвакуумному середовищі на найбільш простому і дешевому обладнанні.
-
Методи вивчення характеристик дифузiйних шарiв.
До основних параметрів дифузійних шарів відносяться:
-
1) питомий поверхневий опір шару;
-
2) глибина, на якій утворюється р-n-перехід;
-
3) концентрація домішок на поверхні.
-
Поверхневий опір вимірюється чотиризондовим методом.
Для цього на поверхні кремнію по довжині легованої області розміщують 4 зонди на одній лінії на однаковій відстані один від одного. Через зовнішні зонди пропускають струм, а внутрішні служать для вимірювання спаду напруги компенсаційним методом.
-
Для вимірювання глибини р-n-переходу найбільш поширений метод, суть якого полягає в виготовленні косого, кулькового, циліндричного шліфів на пластині з послідуючою дією на область шліфа хімічних реагентів. Використані реагенти здатні змінювати колір різним чином у напівпровідниках з електронною та дірковою провідністю – метод деколірування.
-
Різниця в зафарбовуванні шарів може відбуватися через різну швидкість протікання хімічних реакцій.
-
Хімічним зафарбовуванням можна встановити не тільки розташування р-n-переходів а і переходів n+-n, p+-p. Шліфи виготовляються під кутом 1-5˚, що дозволяє розширити досліджувану ділянку.
-
Глибина р-n-переходу, косого під кутом a та шарового визначається із співвідношень:
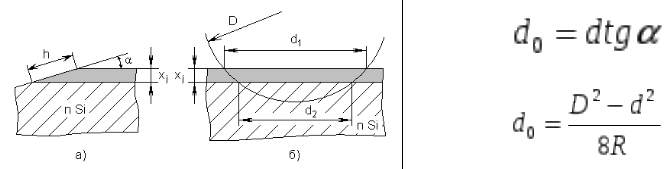
Найбільш поширений деколіруючий розчин складається із концентрованої плавікової кислоти HF та 0,1% азотної кислоти HNO3. При нанесенні цього травника на шліф області з провідністю p-типу темнішають, колір області n-типу не змінюється.
Для визначення поверхневої концентрації дифузійного шару вимірюють поверхневий опір шару та глибину d0. Це дозволяє визначити питому провідність s.
Знаючи ці величини розраховують поверхневу концентрацію. В умовах виробництва користуються готовими графіками N(s).
Розглянутий процес термічної дифузії має ряд недоліків, а саме:
1) висока температура процесу приводить до перерозподілу домішок в раніш сформованих шарах та зміщенню р-n-переходу, що затруднює відтвореність активної області транзистора(бази) товщиною менше, ніж 0,6 мкм;
2) наявність бокової дифузії збільшує площу окремих дифузійних областей;
3) залежність коефіцієнта дифузії та розчинності домішки від температури виключає можливість використання багатьох напівпровідників та легуючих елементів, перспективних для мікроелектроніки.
Тому поряд з термічною дифузією використовується метод іонної імплантації для введення домішок в напівпровідник.
В3
-
Методи нанесення фоторезистів.
Для нанесення фоторезисту на підкладку можна використовувати такі способи: 1 – центрифугування; 2 –пульверизацію; 3 – занурення у розчин; 4 – поливання.
Найбільш поширеним методом є центрифугування.
Схема центрифуги для нанесення шару фоторезисту наведена на рис. 2. Пластину установлюють на платформу центрифуги, де вона утримується вакуумним затискачем. На неї з дозатора наносять декілька крапель фоторезисту і вмикають привід обертання пластини. Під дією відцентрових сил фоторезист розтікається по поверхні пластини, а його лишки викидаються у збірник. Товщина фотошару залежить від частоти обертання платформи та в'язкості розчину.
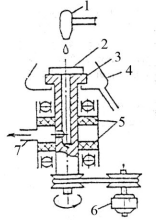
Рисунок 2 – Схема центрифуги для нанесення шару фоторезисту: 1 – дозатор; 2 - пластина; 3 – платформа; 4 – збірник лишок; 5 – вакуумне ущільнення; 6 – електродвигун; 7 – трубопровід до форвакуумного насоса
Найпоширенішим пристроєм для нанесення фоторезисту є агрегат АФФ-2. За допомогою нього можна наносити фоторезист на 12 пластин одночасно і здійснювати подальше сушіння з конвективним або інфрачервоним нагрівом. Технічні характеристики АФФ-2 наведені у табл.. 1.
При центрифугуванні утворюється характерний дефект – крайове стовщення. Це пов'язано з тим, що при розтіканні краплини утворюється концентраційний валик,
який переміщується до країв підкладки. Метод центрифугування не придатний для одержання відносно товстих шарів (d > 3 мкм) та погано піддається автоматизації. У плівках, які висохли в умовах дії центробіжних сил, виникають внутрішні напруження.
При розпиленні названих недоліків і обмежень не виникає, якщо фоторезист диспергується зі стиснутим газом (наноситься на пластину у вигляді аерозолів). Метод розпилення дозволяє в автоматичному циклі вести багатомірну обробку пластин та наносити шари товщиною від 0,3 до 20 мкм з точністю 5 %.

Найбільш поширеним пристроєм для зазначеного методу нанесення є напівавтомат ПНФ-1Р (рис. 3), технічні характеристики якого наведені у табл. 2. Фоторезист наноситься на пластини у процесі зворотно-поступального руху стола. Швидкість руху стола та форму "факела" форсунки можна регулювати. Практика показує, що в плівках, одержаних методом розпилення фоторезисту,Найбільш поширеним пристроєм для зазначеного методу нанесення є напівавтомат ПНФ-1Р (рис. 3), технічні характеристики якого наведені у табл. 2. Фоторезист наноситься на пластини у процесі зворотно-поступального руху стола. Швидкість руху стола та форму "факела" форсунки можна регулювати. Практика показує, що в плівках, одержаних методом розпилення фоторезисту,витрати фоторезисту приблизно у десять разів менші порівняно з першим методом. Відсутність крайового потовщення робить метод розпилення особливо ефективним при нанесенні фотошару на прямокутні підкладки плівкових мікросхем. Як інжекторний газ використовують фреон 131.
