ВУЗ: Не указан
Категория: Не указан
Дисциплина: Не указана
Добавлен: 20.03.2024
Просмотров: 21
Скачиваний: 0
В
его основе реакция разложения силана:
SiH4(г)![]() Si(тв)+
2H2(г) Т≈1000°С.
Si(тв)+
2H2(г) Т≈1000°С.
Так как в этом методе температура ниже, чем в хлоридном, то уменьшается диффузия примесей.
Реактор для эпитаксиального роста обычно совмещают с установкой синтеза моносилана. Его получают двумя путями: по реакции
SiCl4 +
LiAlH4
(гидрид)![]() SiH4 +
LiCl + AlCl3
SiH4 +
LiCl + AlCl3
или
MgSi + 2H2 → SiH4 + 2MgO.
SiH4 – безцветный газ, самовоспламеняющийся при контакте с воздухом. При добавлении 5% Н2или Ar теряется способность к самовоспламенению. Ткип=161К, Тзатв=88,3К, Ркрит=48,3 атм. Хранят в баллонах при 60 атм. Оптимальная концентрация SiH4 в реакторе 0,04 об %. Оптимальная температура процесса 1050÷1100°С. Скорость роста пленки в этих условиях ~ 0,8 мкм/мин, концентрация до 10-4 об. % (PH3, AsH3, B2H6).
При утворенні епітаксійних шарів відбувається інтенсивне впровадження домішки, яка є в підкладці, - в епітаксійний шар. Це особливо помітно при нарощуванні високоомних шарів на сильноліговані підкладки. Прикладом можуть слугувати біполярні мікросхеми, в яких епітаксійний шар n- типу нарощується на сильнолігований «скритий» n+- шар.
При автолегуванні впровадження домішки з підкладки обумовлено травленням підкладки ( при реакції з хлористим воднем ). В результаті такого травлення утворюються не тільки хлориди кремнію, але й хлориди домішок.
На рис.2 показано розподіл домішки в епітаксійному шарі, вирощеному на підкладці n+ - типу.
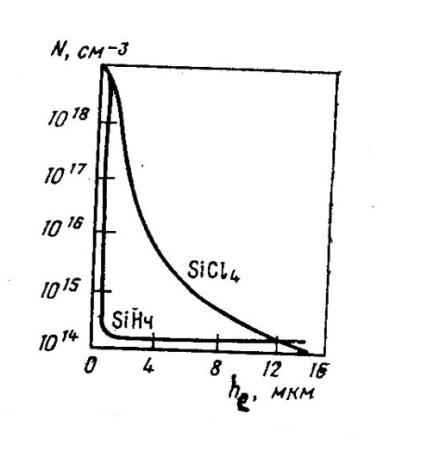
Рисунок
2 - Розподіл домішки в епітаксійному
шарі товщиною ![]() ,
вирощеному на підкладці
,
вирощеному на підкладці ![]() -
типу.
-
типу.
Хлориновий ( хлоридний ) метод обмежує одержання тонких епітаксійних шарів. Для вирішення цієї задачі використовується силановий метод, в основі якого лежить реакція піролітичного розкладання моносилану:
![]()
При
силановому методі використовують
установки, аналогічні тим, що застосовуються
при хлоридному методі. Реакція
піролітичного розкладу починається
при температурі ![]() .
Ріст якісних шарів проходить при
температурі біля
.
Ріст якісних шарів проходить при
температурі біля ![]() .
Переваги силанового методу: більш низька
температура процесу. Крім того, при
силановому методі не утворюється ніяких
галогенідів, здатних травити підкладку
і, тим самим, переносити домішку через
газову фазу в зростаючий епітаксійний
шар.
.
Переваги силанового методу: більш низька
температура процесу. Крім того, при
силановому методі не утворюється ніяких
галогенідів, здатних травити підкладку
і, тим самим, переносити домішку через
газову фазу в зростаючий епітаксійний
шар.
В6
-
Проекційна електронолітографія.
Проекційна електронна літографія. Схема установки для проекційної електронної літографії наведена на рис. 6.
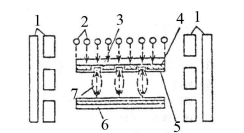
Рисунок 6 – Схема установки проекційної електронної
літографії: 1 – система форсування та відхилення; 2 –
ультрафіолетові лампи-освітлювачі; 3 – кварцова пластина;
4 – плівка двоокису титану; 5 – плівка паладію; 6 –
окислена пластина кремнію з плівкою резисту; 7 –
траєкторія електрона
У цій установці основним елементом є освітлювач ультрафіолетовим світлом фотокатода. Останній є одночасно і джерелом електронів, і шаблоном із рисунком тієї конфігурації, яку потрібно одержати на підкладці.
Фотокатод – це полірована кварцова пластина, на поверхні якої нанесена плівка двооксиду титану за рисунком, що відповідає одному із шарів мікросхеми. На цю плівку наносять шар паладію товщиною близько 4 нм. Вибір цих
матеріалів обумовлений чудовим поглинанням ультрафіолетового світла плівками двооксиду титану та гарними фотоемісійними властивостями паладію. Ті ділянки паладію, що не захищені двооксидом титану, під
дією ультрафіолетового світла випромінюють електрони. Електрони вилітають під різними кутами до поверхні, потім прискорюються електричним полем, фокусуються та направляються на покриту резистом підкладку. Суміщення рисунків проводять за допомогою маркерних знаків,
створених у процесі першої літографії. Порівняно з установкою експонування ця вирізняється більш високою продуктивністю. Загальний недолік усіх систем електронної літографії
полягає у необхідності тримати підкладки у вакуумі, що в цілому ускладнює технологічний процес літографії. Тому електронна літографія найбільш ефективно використовується для створення фотошаблонів та шаблонів для рентгенопроменевої та іонної літографій.
-
Загальна характеристика iонної імплантації
Пучок позитивно заряджених іонівдомішки у іонно-променевому прискорювачі бомбардує кристал напівпровідника. Проникаючи у кристал, домішкалегує його і разом з тим викликає утворення радіаційних дефектів, погіршуючи тим самим його електрофізичні параметри. Розподіл концентрації атомів домішки у кристалі описується кривою Гауса, основним параметром якої є пробіг прискорених іонів. Глибина заглиблення іонів залежить від їх енергії та маси. Концентрація домішки в імплантованому шарі залежить від густини струму в іонному пучку і часу проведення процесу (експозиції). При невеликих дозах опромінення радіаційні дефекти не змінюють кристалічної структури напівпровідника, тоді як великі дози опромінення домішковими атомами призводять до аморфізації кристалу. Для усунення дефектів і впорядкуваннякристалічної ґратки кремнію виконують віджиг кристалу при температурі 500–800 °C.
-
Фiзичнi основи процесу іонної імплантації.
Процес іонної імплантації й нинішній стан модифікованих верств характеризуються такими основними параметрами, зміну яких надає визначальним чином вплинути на властивості оброблюваних поверхонь:
1) Розподіл впроваджених атомів за "товщиною. Воно залежить від енергії іонів, природи матеріалу підкладки, температури поверхні. Для регулювання профілю розподілу щільності легуючих атомів, як зазначалось, використовується додаткова термообробка.
2) Максимальна допустима доза легування – кількість іонів, впроваджених на одиниці поверхні оброблюваної деталі. Зазвичай, ця доза у межах D = 1016…1018ион/см2.
3) Параметри, що характеризують взаємодія іонів з атомами поверхневого шару (швидкість освіти дефектів, характері і структура які виникають хімічних сполук тощо. буд.).
4) Параметри, що визначають зміни структури та властивостей легованих верств залежно від дози опромінення, щільності радіаційних дефектів тощо.
Основний характеристикою ступеня обробки при іонної імплантації є розподіл імплантованих іонів за "товщиною поверхневого шару. При взаємодії іона з поверхнею у процесі багатократних сутичок з атомами мішені відбувається передача кінетичною енергії, і через це іон,внедрившийся на деяке відстань від поверхні, втрачає цю енергію повністю. Для характеристики цього процесу використовують такі параметри: пробіг іона R – це, що відбувається іон до втрати кінетичній енергії (виходячи з експериментальних даних цей параметр визначити складно); проекцію пробігу іонаRx – відстань, яким укорінювався іон від поверхні
В8
-
Іонна літографія.
Для виготовлення мікросхем із субмікронними
розмірами елементів, перспективним є метод іонної
літографії. Він грунтується на тому, що потоки іонів різних газів (водень, гелій, неон, фреон) прискорюються до енергії 60 - 100 кеВ та можуть привести у деяких
речовинах до перебудови молекулярної структури та зміни хімічних властивостей.
Експонування резистів здійснюється фокусуванням або коліміруванням пучків іонів. У першому випадку заданий рисунок одержується скануванням сфокусованого пучка по поверхні підкладки з нанесеним резистом, у другому – опромінюванням шаблона, розміщеного над поверхнею підкладки. Шаблон – це кремнієва мембрана, на якій із плівки золота створюється рисунок маски. Товщина плівки золота достатня для поглинання іонів і становить 700 нм. Суміщення здійснюється у процесі детектування іонів, зворотно розсіяних від спеціально виготовлених маркерних поміток. Точність суміщення становить ±0,05-0,1 мкм, роздільна здатність – 0,2 мкм. Порівняно з електроннопроменевою літографією при іонній значно знижується розмір області, що експонується за рахунок дії на резист частинок, тому можна зменшити розмір елементів у субмікронному діапазоні і, таким чином, у два - п'ять разів підвищити ступінь інтеграції мікросхем. На відміну від електронної літографії, де з метою зниження розмірів елементів використовують тонкі шари резисту, при іонній використовують товсті шари до 1 мкм. Можливість збільшити товщину резисту призводить до того, що густина дефектів стає низькою, а це призводить до підвищення ймовірності виходу придатних мікросхем. На завершення потрібно відмітити, що, змінюючи склад іонів у пучках, можна повністю сформувати структуру напівпровідникових мікросхем, використовуючи при цьому пучки елементів III та V груп періодичноїсистеми для легування приповерхневих шарів кремнію.Цей метод є найбільш перспективним і відкриває новий напрямок у технології мікросхем: формування структур елементів іонним проникнення домішок методом прецизійного сканування сфокусованого іонного пучка без використання резистів та шаблонів.
В5, 7
-
Фоторезисти. Означення, порівняльна характеристика негативних та позитивних фоторезистів.
Фоторезисти. На кожній стадії літографічного процесу діють фактори, які спотворюють рисунок фотошаблону. Такі фактори дуже чітко виявляються у товстих фотошарах. Практично встановлено, що товщина фотошару повинна в 3-4 рази бути меншою від мінімальних розмірів елементів рисунка. Крім цього, набухання товстих плівок у водних розчинах викликає внутрішні напруження та знижує адгезію. З іншого боку, товщина фотошару повинна бути достатньою, щоб протидіяти дії реактивів та перекривати локальні дефекти у структурі фотошару. Товщину фотошару вибирають у межах 0,5 - 1,5 мкм. Залежності від механізму фотохімічних процесів, що проходять під дією випромінювання, розчинність експонованих ділянок фоторезисту може зростати або зменшуватись. У першому випадку фоторезисти мають назву позитивних, у другому – негативних. Таким чином, плівки позитивних фоторезистів під дією випромінювання стають нестійкими і розчиняються у процесі проявлення
